刻蚀设备行业分析报告
刻蚀技术解析:半导体工艺的“点睛之笔”
半导体晶圆厂可以分为6 块相对独立的生产区域:扩散、光刻、刻蚀、离子注入、薄膜沉积和抛光,分别对应6 个主要的制作工艺。
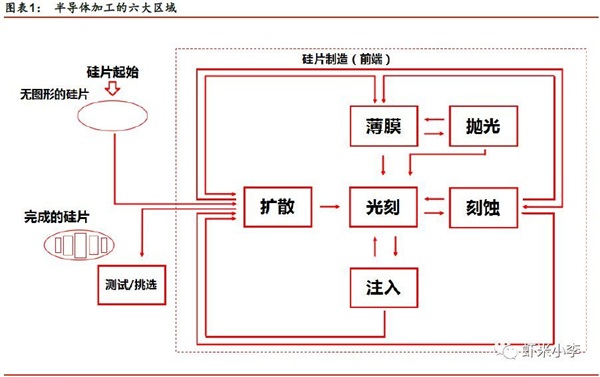

刻蚀环节是复制掩膜图案的关键步骤,干法刻蚀是芯片制造主要技术路径
刻蚀是使用化学或者物理方法有选择地从硅片表面去除不需要材料的过程,常用的设备为刻蚀机等。通常的晶圆加工流程中,刻蚀工艺位于光刻工艺之后,有图形的光刻胶层在刻蚀中不会受到腐蚀源的显著侵蚀,从而完成图形转移的工艺步骤。

为在硅片表面材料上复制掩膜图案,刻蚀需要满足一定的参数,主要有:刻蚀速率、刻蚀剖面、刻蚀偏差和选择比等。刻蚀速率指刻蚀过程中去除硅片表面材料的速度;刻蚀剖面指的是刻蚀图形的侧壁形状,通常分为各向同性和各向异性剖面;刻蚀偏差指的是线宽或关键尺寸间距的变化,通常由横向钻蚀引起;选择比指的是同一刻蚀条件下两种材料刻蚀速率比,高选择比意味着不需要的材料会被刻除。

刻蚀工艺主要分为两种:干法刻蚀和湿法刻蚀。干法刻蚀是通过等离子气与硅片发生物理或化学反应(或结合物理、化学两种反应)的方式将表面材料去除,主要用于亚微米尺寸下刻蚀,由于具有良好的各向异性和工艺可控性已被广泛应用于芯片制造领域;湿法刻蚀通过化学试剂去除硅片表面材料,一般用于尺寸较大情况,目前仍用于干法刻蚀后残留物的去除。

干法刻蚀是芯片制造领域最主要的表面材料去除方法,拥有更好的剖面控制。干刻蚀法按作用机理分为:物理刻蚀、化学刻蚀和物理化学综合作用刻蚀。物理和化学综合作用机理中,离子轰击的物理过程可以通过溅射去除表面材料,具有很强的方向性。离子轰击可以改善化学刻蚀作用,使反应元素与硅表面物质反应效率更高。综合型干刻蚀法综合离子溅射与表面反应的优点,使刻蚀具有较好的选择比和线宽控制。

在集成电路制造过程中需要多种类型的干法刻蚀工艺,应用涉及硅片上各种材料。被刻蚀材料主要包括介质、硅和金属等,通过与光刻、沉积等工艺多次配合可以形成完整的底层电路、栅极、绝缘层以及金属通路等。

介质的干法刻蚀主要包括氧化物刻蚀和氮化硅的刻蚀,是最复杂的刻蚀过程。刻蚀氧化物通常是为了制作接触孔和通孔。要求在氧化物中刻蚀出具有高深宽比的窗口,通常采用氟碳化合物化学气体。对氮化硅的刻蚀常用的气体是𝐶𝐹4,并与𝑂2和𝑁2混合使用。
硅的等离子体干法刻蚀是硅片制造中的一项关键工艺技术,主要作用为制作MOS 栅结构、器件隔离和DRAM 电容结构中的单晶硅槽。多晶硅栅的结构对刻蚀要求很高,必须对下层栅氧化层有高的选择比并具有非常好的均匀性和可重复性。多晶栅刻蚀通常采用氟基气体。单晶硅刻蚀主要用于制作沟槽,要求每个沟槽都要保持一致的光洁度、接近的垂直侧壁、正确的深度和圆滑的沟槽顶角和底角。对浅槽的刻蚀使用氟气,对光刻胶有高选择比。对深槽刻蚀常采用氯基或溴基气体,刻蚀速率高并对氧化硅有高的选择比。
金属刻蚀主要应用于金属互连线、通孔、接触金属等环节。金属互连线通常采用铝合金,对铝的刻蚀采用氯基气体和部分聚合物。钨在多层金属结构中常用作通孔的填充物,通常采用氟基或氯基气体。